シリコンウエハー
シリコンウエハー(Silicon wafer)について
シリコンウエハーはケイ素(Si)の塊であるシリコンインゴットをスライスし、
研磨や洗浄などの工程を行い作成される円状の薄い基板です。
またシリコンウエハーの製造には高純度のシリコンの塊が用いられ、
様々な工程を経てクリーン度の高い基板に仕上げられます。
その中でもプライムレベルの基板はシステムLSIなどの半導体集積回路や、
様々な半導体デバイスにおいてとても重要で欠かせない存在となっています。
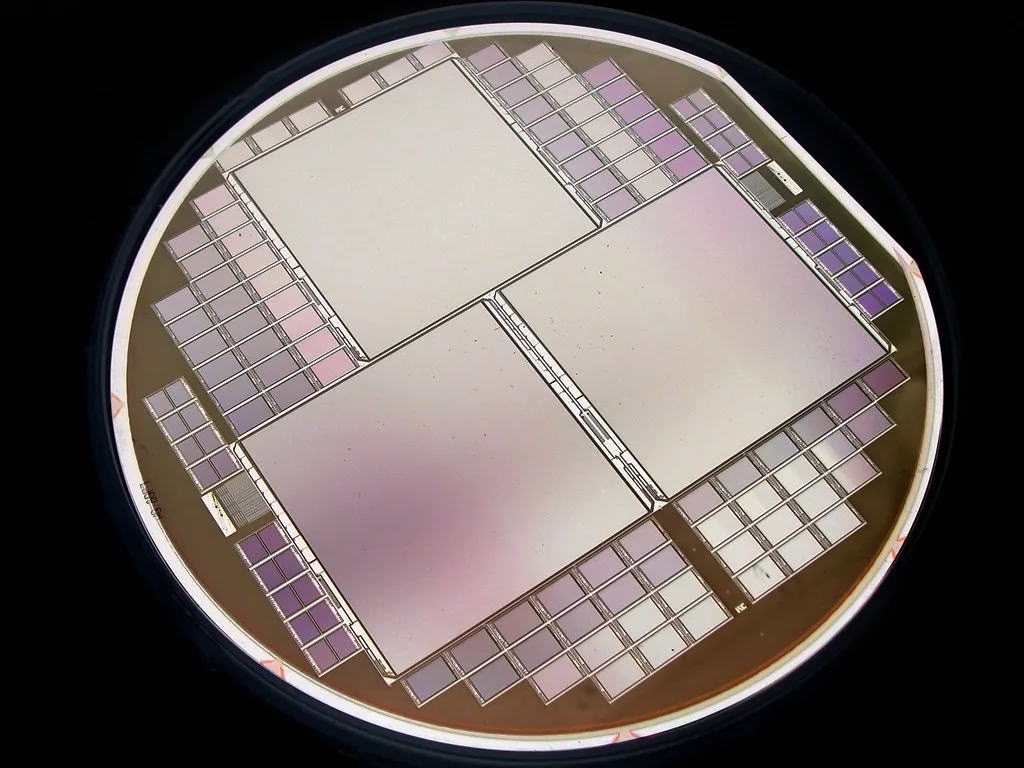

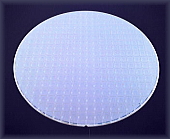
シリコンウエハーに関する概要
| シリコン(ケイ素/Si)とは | シリコンウエハーとは |
シリコンウエハー製造工程
| シリコンウエハー製造工程①(インゴット) | シリコンウエハー製造工程②(スライシング) |
| シリコンウエハー製造工程③(べべリング) | シリコンウエハー製造工程④(ラッピング) |
| シリコンウエハー製造工程⑤(エッチング) | シリコンウエハー製造工程⑥(アニーリング) |
| シリコンウエハー製造工程⑦(ポリッシング) | シリコンウエハー製造工程⑧(クリーニング) |
シリコンウエハー概要
シリコン(ケイ素/Si)とは >>
 シリコン(ケイ素/Si)は地球上の地殻部に最も多く含まれている元素であり、
シリコン(ケイ素/Si)は地球上の地殻部に最も多く含まれている元素であり、酸素と結合し二酸化ケイ素(SiO2)の状態で存在しています。
結晶構造はダイヤモンド構造の立方晶系で、
ホウ素やリンなどの微量な不純物を添加することで、
p型半導体やn型半導体が容易に形成できるため半導体基板などに多く利用されています。
また半導体以外にも赤外光学系のレンズや有機ケイ素化合物など工業用品として、
幅広く使用されています。
| シリコン(ケイ素/Si)の組成 | |||
| 元素名 | ケイ素(Si) | 元素番号 | 14 |
| 融 点 | 1414℃ | 沸点 | 2355℃ |
| 結 晶 構 造 | 立方晶系 | モース硬度 | 7 |
| 結 晶 密 度 | 2.33g/㎝3 | バンドギャップ | 0℃1.206eV |
| 熱 伝 導 率 | 0℃168W/(m・K) | 熱膨張率 | 20℃2.6μm/(m・K) |
シリコンウエハー概要
シリコンウエハーとは >>
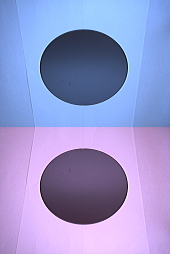 シリコンウエハーはケイ素(Si)からつくられた円形状の薄い基板です。
シリコンウエハーはケイ素(Si)からつくられた円形状の薄い基板です。半導体に用いられるシリコンの純度はイレブンナインと呼ばれ、
99.999999999%という非常に高純度に精製したインゴットからスライスや研磨、
洗浄など様々な工程を経て平坦度やクリーンレベルの高いウエハーがつくられます。
また半導体製造用途のほかクリーンルーム内におけるパーティクルチェックや、
半導体製造装置などにおける搬送テストなどにも使用され、
様々な工程においてとても重要な役割を果たしています。
またシリコンウエハーにはJEITA(電子情報技術産業協会)及び
SEMI(国際半導体製造装置材料協会)で規格が定められていて、
一般的なシリコンウエハーはこの規格に基づき加工・製造されます。

| シリコンウエハー標準規格表(JEITA) | ||||||||
| 項 目: | Unit | 仕 様 | ||||||
| サ イ ズ: | inch | 2 | 3 | 4 | 5 | 6 | 8 | 12 |
| 直 径: | mm | 50.0 | 76.0 | 100.0 | 125.0 | 150.0 | 200.0 | 300.0 |
| 厚 み: | μm | 280 | 380 | 525 | 625 | 625 | 725 | 775 |
| オ リ フ ラ: | mm | 17.5 | 22.0 | 32.5 | 42.5 | 47.5 | 57.5 | 60.0 |
| シリコンウエハー標準規格表(SEMI) | ||||||||
| 項 目: | Unit | 仕 様 | ||||||
| サ イ ズ: | inch | 2 | 3 | 4 | 5 | 6 | 8 | 12 |
| 直 径: | mm | 50.8 | 76.2 | 100.0 | 125.0 | 150.0 | 200.0 | 300.0 |
| 厚 み: | μm | 279 | 381 | 520 | 625 | 675 | 725 | 775 |
| オ リ フ ラ: | mm | 15.8 | 22.2 | 32.5 | 42.5 | 57.5 | ノッチ | ノッチ |
シリコンウエハー製造工程
シリコンウエハー製造工程①(インゴット) >>
 シリコンウエハーの主原料となるシリコンは珪石という鉱物から生成されます。
シリコンウエハーの主原料となるシリコンは珪石という鉱物から生成されます。この珪石を還元・精留により多結晶シリコンに加工します。
このとき微量な不純物を加えることでウエハーの電気特性が決定されます。
不純物にはP型の場合はBoron、N型の場合はPhosのほかSbやAsなどがあります。
また半導体デバイスなどの基板に用いるためには、
シリコンを高純度に精製する必要があるため、
さらに多結晶シリコンを溶解し大きく細長い棒状の単結晶に仕上げます。
このようにして精製されたものが、
シリコンウエハーを加工するためのインゴットとなります。
インゴットの精製法は主に2種類の製法があり、
溶解したシリコンから単結晶を引き上げるCZ(チョクラルスキー)法や、
部分的に溶解しながら単結晶化を行うFZ(フローティングゾーン)法などがあります。
| インゴット製法 | ||
| 製 法 区 分 | CZ法(チョクラルスキー法) | FZ法(フローティングゾーン法) |
| 使 用 材 料 | 多結晶シリコン |
|
| 結 晶 成 長 速 度 | 遅い | 速い |
| 溶 融 区 分 | 間接溶融(るつぼ使用) | 直接溶融(るつぼ不使用) |
| 不 純 物 濃 度 | 高 | 低 |
| 主 な 用 途 | ICデバイス、LSIなど | パワー半導体、光学製品など |
シリコンウエハー製造工程
シリコンウエハー製造工程②(スライシング) >>
 単結晶インゴットを外周研削し直径を均一にした後、
単結晶インゴットを外周研削し直径を均一にした後、ワイヤーソーや内周刃切断装置などでスライスしウエハー形状にカットします。
このスライシング工程時に結晶方位やオリフラ方位などが決められます。
カットされたウエハーはアズカットウエハー、アズスライスウエハーなどと呼ばれ、
この状態ではまだ面の状態が粗く厚みもバラつきのある状態となります。
スライシングはシリコンウエハーの製造工程における初めの重要なプロセスで、
スライシングの精度が低いとウエハーの厚みなどにばらつきが生じ、
歩留まりの低下や品質に大きく影響するため高精度の加工が必要となります。
スライシングには主に3つの手法があり、
スラリー(研磨剤液)を用いて切断する遊離砥粒方式のほか、
ワイヤやブレードに砥粒を固定する固定砥粒方式、
電気やレーザーなどで切断する非接触方式などがあります。
| スライシング手法 | |||
| スライシング方式 | 遊離砥粒 | 固定砥粒 | 非接触 |
| 加 工 速 度 | 遅い | 速い | 材料による |
| 機 械 ダ メ ー ジ | 低 | 中 | 無 |
| 熱 性 ダ メ ー ジ | 低 | 中 | 高 |
シリコンウエハー製造工程
シリコンウエハー製造工程③(べべリング) >>
 スライスされたウエハーの側面をダイヤモンド砥石などで面取り加工を行い、
スライスされたウエハーの側面をダイヤモンド砥石などで面取り加工を行い、エッジ外周部の形状を整えスライス時の歪みを矯正し正円にします。
標準的な工程ではR面取り(ラウンド面取り)を行い丸みを帯びた形状に仕上げます。
面取りがされていないと研磨工程やハンドリングにおいて、
外力によるカケやチッピングなどのリスクが生じるため、
これらを抑制しウエハーの強度を強めるためにもとても重要な工程となります。
また面取りされたウエハーは強度を向上させるだけでなく、
発塵が低減されることで製造工程における歩留まりの安定化にも繋がります。
また後工程ではラウンド面取りのほか角度をつけたC面取りや
バリや角を除去する目的の糸面取りなどのプロセスがあります。
| べべリング手法 | |||
| べべリング方式 | R面取り | C面取り | 糸面取り |
| べ べ リ ン グ 形 状 | 円型 | 角型 | 小角型 |
| 主 な 目 的 | 強度向上・発塵抑制 | カケ・チッピング防止 | バリ・角除去 |
シリコンウエハー製造工程
シリコンウエハー製造工程④(ラッピング) >>
 ラップ盤と呼ばれる円盤状の装置にウエハーを載せて、
ラップ盤と呼ばれる円盤状の装置にウエハーを載せて、ラップ材(アルミナやSiCの液状研磨材)を流し込みながら上下両面に圧力をかけて研磨し、厚みのバラつきや歪み・キズなどを修正し整えます。
ラッピングは粗研磨などとも呼ばれ、スライス後に比べウエハーの平坦度や面粗さが向上しラッピングされたウエハーのことをラップドウエハーと呼びます。
またラッピングには湿式ラッピングと乾式ラッピングがあり、
シリコンウエハー(ラップドウエハー)の製造工程では主に湿式ラッピングが用いられ、
完全な鏡面の状態ではなく光沢のない梨地のような状態に仕上げられます。
そのため表面の状態はスライス後と比較すると滑らかな状態になっていますが、
最終仕上げのポリッシング工程に比べると精度が低い状態となります。
| ラッピング手法 | ||
| ラッピング方式 | 湿式ラッピング | 乾式ラッピング |
| ラ ッ プ 材 料 | アルミナ、SiC、ダイヤモンドスラリーなど |
|
| 砥 粒 区 分 | 遊離砥粒 | 固定砥粒 |
| 加 圧 レ ベ ル | 低圧 | 高圧 |
| 仕 上 精 度 | 中 | 高 |
| 仕 上 状 態 | 梨地(光沢無し) | 鏡面(光沢有り) |
| 主 な 用 途 | 粗仕上げ、中間仕上げ | 精密仕上げ、最終仕上げ |
シリコンウエハー製造工程
シリコンウエハー製造工程⑤(エッチング) >>
 ラッピング工程で残存している歪みやキズをエッチングにより除去します。
ラッピング工程で残存している歪みやキズをエッチングにより除去します。エッチングには酸やアルカリなどの薬液との化学反応でプロセスを行う
ウェットエッチングと、反応性ガスやプラズマにより生成されるイオンにより
プロセスを行うドライエッチングがあり、
ラップ工程後のシリコンウエハーの製造工程では
主にウェットエッチングにより加工を行います。
エッチング処理されたウエハーはエッチドウエハーと呼ばれ、
表面のより細かな歪みやキズのほか、不純物やパーティクルなども除去され
ラップドウエハーよりも精度の高い状態に仕上げられます。
| エッチング手法 | ||
| エッチング方式 | ウェットエッチング | ドライエッチング |
| プ ロ セ ス 区 分 | 化学 | 物理、物理+化学 |
| プ ロ セ ス 方 式 | 酸、アルカリなど | ガス、スパッタ、プラズマなど |
| 使 用 材 料 | 液体(硝酸、フッ酸、リン酸等) | 気体(フッ化水素、アルゴン等) |
| 処 理 速 度 | 速い | 遅い |
| 処 理 精 度 | 低 | 高 |
| 主 な 目 的 | 広範囲加工、表面のダメージ除去 | 微細加工、回路パターン形成 |
シリコンウエハー製造工程
シリコンウエハー製造工程⑥(アニーリング) >>
 ウエハーを熱処理しシリコン内の酸素ドナーを消滅させます。
ウエハーを熱処理しシリコン内の酸素ドナーを消滅させます。酸素ドナーはウエハーの電気特性を不安定な状態にするため、
酸素ドナーの除去はデバイス特性の向上やウエハー品質の安定化において、
欠かすことができない非常に重要な工程となります。
シリコンウエハーの製造工程内ではドナーキラーアニーリングと呼ばれ、
約600-800℃の温度で熱処理を行い結晶欠陥を低減させることで、
結晶構造を改善し抵抗値を安定化させます。
アニーリングにはバッチ式や枚葉式、レーザーなどの方式がありますが、
ポリッシング工程前の一般的なシリコンウエハーの製造工程では、
一度に多くの枚数を処理することができるバッチ式で加工を行います。
| アニーリング手法 | |||
| アニーリング方式 | バッチ式 | 枚葉式 | レーザー |
| 加 熱 方 法 | ヒーター | 赤外線 | 紫外線 |
| 処 理 速 度 | 遅い | 速い | 速い |
| 処 理 枚 数 | 多い | 少ない | 少ない |
| 主 な 目 的 | 強度向上・発塵抑制 | カケ・チッピング防止 | バリ・角除去 |
シリコンウエハー製造工程
シリコンウエハー製造工程⑦(ポリッシング) >>
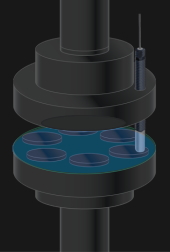 CMP(Chemical Mechanical Polishing)と呼ばれる装置にウエハーを載せて研磨し、
CMP(Chemical Mechanical Polishing)と呼ばれる装置にウエハーを載せて研磨し、表面に残存しているキズや歪み、不純物などを除去し、
表面の平坦性を向上させ高精度な状態に仕上げます。
CMPによるポリッシングでは薬液や水溶液による化学的な研磨作用と、
砥粒による機械的研磨作用の2つの作用を用いて加工を行います。
ポリッシングはシリコンウエハーの製造工程内における
表面の平坦精度を向上させる工程の中で最終仕上げの工程となるため、
高精度で高品質なウエハーを製造するうえでとても重要な工程となります。
ポリッシングされたウエハーはポリッシュドウエハーと呼ばれ、
標準的な工程ではウエハーの片面が鏡面の状態に仕上げられます。
| ポリッシング手法 | ||
| ポリッシング方式 | CMP(Chemical Mechanical Polishing/ケミカルメカニカルポリッシング) | |
| 研 磨 材 料 | スラリー+研磨パッド |
|
| 研 磨 作 用 | 化学的 | 機械的 |
| 材 料 区 分 | 薬液 | 砥粒 |
| 使 用 材 料 | 酸、アルカリなど | アルミナ、シリカなど |
シリコンウエハー製造工程
シリコンウエハー製造工程⑧(クリーニング) >>
 ウエハー表面に残存している微粒子(パーティクル)や、
ウエハー表面に残存している微粒子(パーティクル)や、金属不純物、有機物などを除去するために薬液や純水を用いて洗浄を行います。
シリコンウエハーの洗浄には液体の薬液を用いて洗浄を行うウェット式と、
ガスやプラズマで洗浄を行うドライ式がありますが、
ウエハー製造工程内における仕上洗浄では主にウェット式で洗浄を行います。
洗浄で清浄度が高められたウエハーは表面の酸化などを防ぐためすぐに乾燥され、
外観検査やパーティクル測定などの検査を経て、
高精度で清浄度の高い高品質のシリコンウエハーが作り上げられます。
| 洗浄手法 | ||
| 洗浄方式 | ウェット式 | ドライ式 |
| 使 用 材 料 | 液体(薬液、純水等) | 非液体(ガス、プラズマ等) |
| 処 理 速 度 | 速い | 遅い |
| 処 理 精 度 | 中 | 高 |
| 主 な 目 的 | 微粒子除去、金属不純物除去 | 微細加工、自然酸化膜除去 |
シリコンウエハーに関するお問い合わせ
シリコンウエハーに関するお問合せ・ご相談は総合お問合せページよりお問合せ下さい。
各種ウエハーをお求めのお客様や御見積をご希望のお客様は下記フォームからもお問い合わせ頂けます。
![]()
【各種ウエハー御見積フォーム】
| モニターウエハー | ダミーウエハー | ソーラーウエハー | 成膜ウエハー | SOIウエハー |
キャノシス株式会社
〒105-0013
東京都港区浜松町2-2-15
浜松町DHビル9階RM903
TEL:03-6904-8095
FAX:03-6740-1750